世界初、ポスト5Gに向けたAlN系高周波トランジスタの動作に成功 ~次世代半導体AlNの応用領域を電力変換から無線通信へ拡大~
配信日時: 2025-12-09 15:11:07
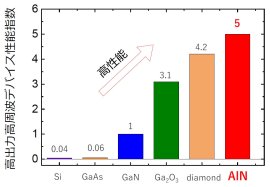
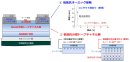

発表のポイント:
NTTが世界に先駆けて半導体化に成功した窒化アルミニウム(AlN)(※1)の半導体技術を発展させ、AlN系高周波トランジスタの動作に世界で初めて成功しました。
これまでAlN系トランジスタの高周波信号増幅を妨げていた高い接触抵抗とチャネル抵抗の課題を、電極‐半導体界面のエネルギー障壁を低減するコンタクト層と高い電子濃度を発生するチャネル構造の設計により克服しました。
AlN半導体が、パワーデバイス(※2)用途にとどまらず無線通信デバイスとしても有望であることを明らかにし、その応用領域のさらなる拡大が期待されます。
NTT株式会社(本社:東京都千代田区、代表取締役社長:島田 明、以下「NTT」)は、窒化アルミニウム(AlN)系トランジスタにおいて、その低抵抗構造の設計により、無線通信で利用する高周波信号の増幅を世界で初めて実現しました。本研究で試作したAlN系高周波トランジスタは、ミリ波帯における増幅が可能であり、今後さらなる高出力化の開発を進めることで、ポスト5G時代の通信エリアの拡大や通信速度の高速化など、無線通信サービスのさらなる向上が期待されます。NTTが世界に先駆けて半導体化に成功したAlNは、その優れた物性値から電力変換に用いられるパワーデバイスへの応用が期待されてきました。今回、無線通信デバイスの動作も初めて実証したことにより、AlNの応用領域が大きく広がる可能性が示されました。
本成果は、2025年12月10日に米国サンフランシスコで開催される国際会議「71st IEEE International Electron Devices Meeting(IEDM 2025)」にて発表予定です。
1.背景
高周波トランジスタは無線通信、衛星通信、レーダーなどに用いられる高周波電力増幅器の中核デバイスです。アンテナから出力される無線信号の出力と周波数が高いほど、通信サービスの向上(通信エリアの拡大や通信速度の高速化)につながります。そのためには、高周波トランジスタでは、高い絶縁破壊電界(※3)と高い飽和電子速度(※4)を兼ね備えた半導体材料が求められます。現在の5G通信では、ワイドバンドギャップ半導体(※5)である窒化ガリウム(GaN)を用いた高周波トランジスタが広く利用されています。
ポスト5Gに向けては、高周波トランジスタのさらなる高出力化を実現するため、より高い絶縁破壊電界をもつ窒化アルミニウム(AlN)、ダイヤモンド、酸化ガリウム(Ga2O3)などのウルトラワイドバンドギャップ半導体(※5)が注目されています。とくにAlNは、半導体で最大級の絶縁破壊電界と飽和電子速度を併せ持つと予測されており、高出力高周波トランジスタとしての性能指数であるJohnson’s Figure of Merit (FoM)(※6)が、GaNの5倍、ウルトラワイドギャップ半導体の中でもっとも高い値を示します(図1)。また、AlNとGaNの化合物である窒化アルミニウムガリウム(AlGaN)では、Al組成を増加させることで性能指数を上げることができます。そこで、Al組成を高めた高Al組成AlGaN(AlN系半導体)をチャネル層(※7)に用いた高周波トランジスタは、次世代の電力増幅器として高いポテンシャルを有しています。
NTTはこれまで、世界で初めてAlNの半導体化に成功するとともに、AlNトランジスタやショットキーバリアダイオードの動作を実証し、パワーデバイス半導体としての可能性を示してきました。しかし、AlN系半導体を高周波トランジスタに用いる際、Al組成を高めると、電極から半導体に十分な電流を流せない、電流の通り道であるチャネル層の抵抗が高くなるといった根本的な問題を抱えていました。このため、Al組成が75%を超えるような高Al組成のAlN系トランジスタでは、長らく「高周波動作は困難」とされてきました。
[画像1]https://digitalpr.jp/simg/2341/124284/400_277_20251208165337693684011dc14.jpg
図1 物性値からの予測される半導体材料の高出力高周波デバイスとしての性能指数
Johnson’s Figure of Merit (GaNで規格化)
2.技術のポイント
本研究では、AlN系トランジスタの高周波動作の実現に向けて、以下の2つの技術を開発しました(図2)。
①AlGaNコンタクト層による低抵抗オーミック接触
従来のAlGaNチャネル層上に電極を直接形成する構造では、Al組成の増加に伴い電極との間に生じるエネルギー障壁が高くなるため、オーミック接触(※8)が得られず、トランジスタのドレイン電流値が低く制限されていました。本研究では、エネルギー障壁を低減するため、電極とチャネル層の間にAl組成を徐々に変化させたAlGaNコンタクト層を形成する技術を開発しました。これにより、オーミック接触抵抗を低減できるようになりました。
②分極ドープチャネル構造による低抵抗化
従来のAlGaNチャネル構造では、Al組成を一定とし、AlN障壁層とAlGaNチャネル層の界面に形成される2次元電子ガスを電気伝導に利用するのが一般的でしたが、高Al組成では2次元電子ガス濃度が低下することからチャネル抵抗が高くなり、ドレイン電流値が低く制限されていました。また2次元電子ガスをチャネル層内に閉じ込めるエネルギー障壁も低く、高いオンオフ電流比が得られていませんでした。本研究では、Al組成を傾斜させたAlGaNチャネル層をAlN障壁層と電荷制御下地層で挟んだ分極ドープ(※9)チャネル構造を新たに考案し、チャネル層内に高濃度の3次元電子ガスを形成できるようになりました。これにより、チャネル抵抗を低減することに成功しました。
[画像2]https://digitalpr.jp/simg/2341/124284/700_337_20251208165337693684011a5f6.jpg
図2 AlN系トランジスタの模式図と技術のポイント
3.研究の成果
これらのオーミック接触抵抗とチャネル抵抗の低減技術を用いて、高Al組成領域のAlN系トランジスタ(Al組成78%、85%、89%)を試作しました。これまではドレイン電流が低く制限されていたAl組成75%以上においても、良好なオーミック接触による線形性の優れた電流の立ち上がりと高いドレイン電流が得られることを確認しました。一例として、Al組成85%のAlN系トランジスタ(図3(a))では、500 mA/mmを越える高いドレイン電流(図3(b))と、109を超える高いオンオフ電流比を示しました。こうしたトランジスタ性能の向上により、従来は高周波動作が困難とされてきたAl組成75%を超えるAlN系トランジスタにおいて、1 GHzを越える高周波での電力増幅動作を世界で初めて実現しました(図4(a))。Al組成85%のAlN系トランジスタでは、電力増幅が可能な最大動作周波数(fmax)(※10)がミリ波帯(30 GHz ~ 300 GHz)の79 GHzに達し、これまで報告されているAlN系トランジスタの中で最高値です(図4(b))。チャネル層のAl組成が高いほど高周波トランジスタの高出力化には有望であるため、今回考案した構造は、AlNが本来有する高いポテンシャルを引き出す設計指針を提示するものであり、AlN系高出力高周波トランジスタの応用に向けた重要な成果となりました。
[画像3]https://digitalpr.jp/simg/2341/124284/600_293_202512081653376936840123b45.jpg
図3 AlN系トランジスタ(Al組成 85%)の(a)電子顕微鏡像(上面から撮影)、
(b)ゲート電圧を+3Vから-9Vまで変化させたときのドレイン電流-電圧特性
[画像4]https://digitalpr.jp/simg/2341/124284/600_297_202512081653376936840127f5d.jpg
図4 (a) AlN系トランジスタ(Al組成 85%)の高周波特性、
(b) AlN系トランジスタのAl組成とfmaxのトレンド
4.今後の展開
本研究では、世界で初めてAl組成が75%を超えるAlN系高周波トランジスタのミリ波帯での電力増幅動作に成功しました。これにより、通信エリアの拡大や通信速度の高速化など、ポスト5G時代の無線通信インフラの発展に向けた重要な第一歩を示しました。今後は、この高周波トランジスタの大電力動作の実証に向けて、より大電流・大電圧の動作が可能なデバイス構造を設計し、パワーデバイスから無線通信まで幅広く応用可能なNTT発のAlN半導体技術の社会実装に向けて研究開発を進めていきます。
5.関連する過去の報道発表
・2022年4月22日「世界初、窒化アルミニウムトランジスタを実現 ~カーボンニュートラルに貢献する次世代パワーデバイスの本命登場~」
https://group.ntt/jp/newsrelease/2022/04/22/220422a.html
・2024年12月10日「窒化アルミニウム系ショットキーバリアダイオードの電流輸送機構を解明
――低炭素社会に寄与する新しいパワー半導体デバイスの実現に向け大きく前進――」
https://group.ntt/jp/newsrelease/2024/12/10/241210a.html
発表学会
学会名:71st IEEE International Electron Devices Meeting(IEDM 2025)
会 期:2025年12月6日〜10日
題 名:First RF Operation of AlGaN-channel Polarization-Doped FETs with Average Al-content Over 0.75
著者名: Seiya Kawasaki, Masanobu Hiroki, Kazuyuki Hirama, Yoshitaka Taniyasu
【用語解説】
※1 窒化アルミニウム(AlN)
アルミニウム(Al)と窒素(N)からなる化合物半導体。Al組成が50%以上の高Al組成AlGaNを含めてAlN系半導体と総称される。
※2 パワーデバイス
電気の直流⇔交流変換や直流電圧の昇圧・降圧、交流の周波数変換を行う電力変換デバイス。家電、電気自動車や鉄道、産業機器、電力インフラなど幅広い分野で利用される。
※3 絶縁破壊電界
半導体材料に電圧をかけた際に、電気的な絶縁を保てなくなり急激に電流が流れ始める電界強度。この値が大きいほど高電圧・高出力で動作する。
※4 飽和電子速度
強電界下で電子が到達できる最大速度。電子速度が速いほど高い周波数(高速)で動作する。
※5 ワイドギャップ半導体、ウルトラワイドギャップ半導体
バンドギャップは半導体の電気的特性を決める物性値。このエネルギー値が大きい半導体ほど絶縁破壊電界は大きくなる。シリコン(Si)のバンドギャップは1.1eV(エレクトロンボルト)。バンドギャップが約3 eV程度と大きいシリコンカーバイド(SiC)やGaNはワイドギャップ半導体と呼ばれる。これらよりもさらに大きなバンドギャップを有するGa2O3、ダイヤモンド、AlNはウルトラワイドギャップ半導体と呼ばれる。
※6 Johnson’s Figure of Merit
高出力高周波トランジスタの性能指数。絶縁破壊電界と飽和電子速度の積に比例する。
※7 チャネル層
トランジスタ内部で電流の通路となる半導体層。ゲート電圧によりチャネル中の電子量を制御することで、電流制御や増幅を行う。
※8 オーミック接触
半導体と金属の界面の電気抵抗が低く、電流が双方向に流れる接触。
※9 分極ドープ
AlGaNの組成を空間的に傾斜させることで、電気的な偏り(分極電荷)を作り出し、3次元電子ガスまたは3次元正孔ガスを発生させる技術。
※10 電力増幅が可能な最大動作周波数(fmax)
トランジスタが電力増幅器として働ける限界の周波数(電力利得が1となる周波数)。高周波増幅器や無線通信回路の設計で重要な指標。
プレスリリース情報提供元:Digital PR Platform
スポンサードリンク
「その他IT・インターネット」のプレスリリース
スポンサードリンク
最新のプレスリリース
- 2026年最新|どんな天気も、好きになる。突然の雨も強い日差しも対応するレイングッズブランド「HUS.」新作登場03/11 02:15
- 生活クラブが農林水産省にパブリックコメントを提出しました03/11 02:15
- 『スマート・メディスン』の視点からみた脳疾患治療:パーキンソン病に対する水素療法の可能性と低濃度療法の意義03/11 02:15
- 「コツメカワウソを用いた観光促進事業」の問題点を解説03/11 02:15
- 「健康経営優良法人 2026(大規模法人部門)ホワイト 500」認定について03/11 02:15
- 最新のプレスリリースをもっと見る
